顶点光电子商城2025年4月21日消息:从晶圆到MEMS(微机电系统)传感器的制造是一个精密且复杂的过程,涉及多个关键工艺步骤。以下是MEMS传感器从晶圆到芯片的制造流程:
1. 晶圆准备
晶圆选择:MEMS传感器通常使用硅晶圆作为基底材料,硅具有良好的机械性能和与微电子工艺的兼容性。晶圆清洗:通过化学清洗和去离子水冲洗,去除晶圆表面的有机物、金属离子和颗粒污染物,确保表面洁净度。
2. 薄膜沉积
绝缘层或结构层沉积:通过化学气相沉积(CVD)或物理气相沉积(PVD)技术,在晶圆表面沉积一层或多层薄膜,如二氧化硅(SiO₂)、氮化硅(Si₃N₄)或多晶硅(Poly-Si)。这些薄膜用于形成传感器的结构层或绝缘层。金属层沉积:在需要导电的区域沉积金属层(如铝、铜或金),用于形成电极或互连线。
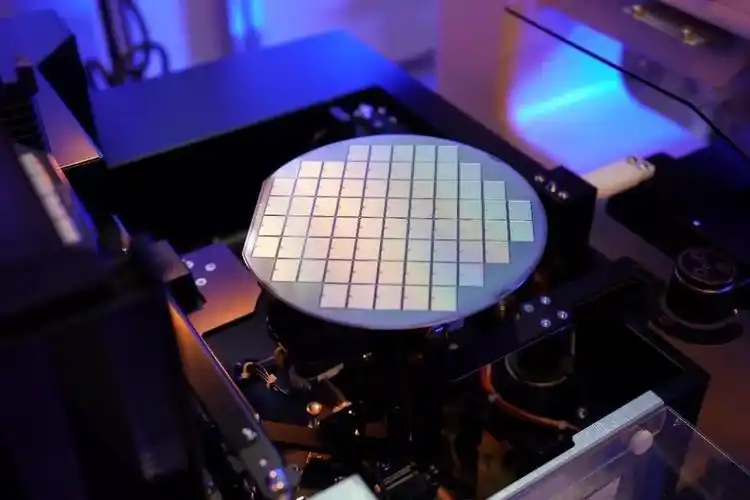
3. 光刻与图形化
光刻胶涂覆:在晶圆表面涂覆一层光刻胶,通过旋涂工艺使其均匀分布。曝光:使用光刻机将掩模版上的图案转移到光刻胶上,通过紫外线曝光使光刻胶发生化学变化。显影:将曝光后的晶圆浸入显影液中,去除未曝光部分的光刻胶,形成所需的图案。
4. 刻蚀
干法刻蚀:利用等离子体对未被光刻胶保护的区域进行刻蚀,形成传感器的三维结构,如悬臂梁、沟槽或空腔。湿法刻蚀:在某些情况下,使用化学溶液进行刻蚀,适用于特定材料的去除。
5. 掺杂与离子注入
掺杂:通过离子注入或扩散工艺,在硅基底中引入杂质原子(如硼或磷),改变其电学性能,形成压阻元件或导电通道。退火:高温退火激活掺杂原子,修复晶格损伤。
6. 释放工艺
牺牲层去除:MEMS传感器中的可动结构(如悬臂梁)通常通过牺牲层技术形成。在结构层沉积后,在需要释放的区域沉积牺牲层材料(如光刻胶或氧化硅)。湿法或干法释放:通过化学刻蚀或等离子体刻蚀去除牺牲层,释放可动结构,形成自由运动的机械部件。
7. 封装
晶圆级封装:在晶圆表面沉积保护层(如聚合物或玻璃),防止器件在后续处理中受损。划片:将晶圆切割成单个芯片。芯片级封装:将单个芯片封装在保护性外壳中,连接引脚或焊盘,便于与外部电路连接。
8. 测试与校准
功能测试:对封装后的芯片进行电学和机械性能测试,确保其满足设计规格。校准:对传感器进行灵敏度、线性度和温度漂移等参数的校准,提高测量精度。
关键技术点,表面微加工与体微加工:MEMS传感器通常采用表面微加工技术(在硅基底表面沉积和刻蚀薄膜)或体微加工技术(从硅基底中刻蚀出三维结构)。深反应离子刻蚀(DRIE):用于形成高深宽比的垂直结构,如MEMS加速度计中的悬臂梁。晶圆级封装:通过在晶圆表面直接沉积保护层,提高传感器的可靠性和稳定性。
应用领域方面,MEMS传感器广泛应用于消费电子、汽车、医疗、工业和航空航天等领域,如加速度计、陀螺仪、压力传感器、麦克风和微镜等。
通过上述工艺步骤,MEMS传感器实现了从晶圆到芯片的精密制造,结合了微电子和微机械技术,为现代科技提供了高性能、小型化的传感解决方案。
 鄂公网安备 42011502001385号 鄂ICP备2021012849号
鄂公网安备 42011502001385号 鄂ICP备2021012849号